
华宇电子推出:Memory产品DDR5_FCBGA82B封装
华宇电子提供专业的存储芯片封装服务,覆盖从晶圆来料检测到成品包装的全流程。 DDR5:FCBGA82B(10*11) FC BGA 图示 Package信息 Package Outline Dimension 公司凭借先进设备、严格工艺控制和全流程服务,可为客户提供高可靠Memory芯片封测解决方案。

华宇电子提供专业的存储芯片封装服务,覆盖从晶圆来料检测到成品包装的全流程。 DDR5:FCBGA82B(10*11) FC BGA 图示 Package信息 Package Outline Dimension 公司凭借先进设备、严格工艺控制和全流程服务,可为客户提供高可靠Memory芯片封测解决方案。

年度员工集体生日会,暖心回顾华宇电子用心服务客户,高质量发展让青春年华充满正能量奋斗记忆期待2026更好的自己! 时光荏苒,岁月如歌,随着十二月生日会的温馨落幕,华宇电子2025年度集体生日会系列活动圆满收官。在这一年中,我们并肩同行,用汗水浇灌成长,用奋斗书写青春,共同筑就了华宇电子这个充满温暖与能量的家园。我们以生日的名义,串联起一整年的温暖记忆,每场生日会都承载着公司对员工的深深关怀。 2025年的生日会不仅是庆祝仪式,更是华宇人成长的见证: 在这里分享工作心得,交流生活感悟; 在这里结识跨部门伙伴,拓展友谊圈; 在这里感受领导关怀,增强归属认同; 在这里暂时放下忙碌,享受片刻轻松。 这些温馨聚会,为“用心服务客户”注入了情感动力,为“高质量发展华宇电子”凝聚了人心力量;这些瞬间构成了华宇人充满正能量的奋斗记忆,让青春年华在温暖中绽放光彩。 感恩2025,期待2026,遇见更好的自己 站在2025的尾端,我们心怀感激;展望2026的开启,我们充满期待。新的一年,让我们继续: 以客户为中心,深耕服务,持续创新 以奋斗者为荣,互相成就,共同成长 以家园为纽带,温暖彼此,聚力前行 期待2026,我们都能遇见更好的自己,携手创造华宇电子更辉煌的篇章!


华宇电子提供专业的存储芯片封装服务,覆盖从晶圆来料检测到成品包装的全流程。 DDR4:WBGA78B(11*7.5)/WBGA96B(13*7.5) Window BGA 图示 Package信息 Package Outline Dimension LPDDR4:FBGA14.5*10(200B) FBGA 图示 Package信息 Package Outline Dimension Process flow NAND Flash:BGA18*12(132B) NAND 图示 Package信息 Package Outline Dimension eMMC:BGA13*11.5(153B) eMMC 图示 Package信息 Package Outline Dimension TF卡:11x15x1.0UDP:24.8×11.3×1.4 公司凭借先进设备、严格工艺控制和全流程服务,可为客户提供高可靠Memory芯片封测解决方案。 产品请联系: 【Memory类产品】业务/技术咨询: 羊先生18956642996宁先生15205668832 【BGA类产品】业务/技术咨询: 孙先生18956622837姚先生13365801569宁先生15205668832 【LGA/FC/QFN/DFN类产品】业务/技术咨询: 何先生19856628226刘先生13916282364 【LQFP类产品】业务/技术咨询: 陈先生18118748119鲍先生18815785911 【TSSOP类产品】业务/技术咨询: 孙先生18956622837王女士15256676374 【SOP8(208MIL)/SOP18/SOP32/MSOP类产品】业务/技术咨询: 胡先生15357786718王女士15256676374 【SOT类产品】业务/技术咨询: 刘先生13866612996鲍先生18815785911

11月20-21日,中国集成电路设计业2025年会(ICCAD 2025) 在成都圆满落幕。华宇电子携先进封装FCBGA一站式解决方案精彩亮相,来自全国各地的行业领袖、技术专家及合作伙伴共襄盛举,深入交流,共绘集成电路产业发展的新蓝图。 华宇展台,焦点所在 展会期间,公司所在D103-104展台始终人气高涨,成为会场焦点之一。我们通过 “产品展示+技术交流+行业探讨” 的多维模式,全面展示了公司在芯片设计、先进封装测试以及一站式解决方案等领域的最新成果。 公司资深市场技术团队坐镇现场,与前来洽谈的新老客户及行业同仁就技术难点、市场趋势和未来合作进行了数十场深度交流。思想的火花在此碰撞,合作的桥梁在此搭建。 搭建平台,专题分享 21日下午,公司在先进封装测试论坛作专题报告,重点探索先进封装测试FCBGA机遇与挑战,从FCBGA时代背景、战略意义到应用前景,从FCBGA发展瓶颈与壁垒、战略优势到技术解决方案,公司系统分析了当前封测形式及未来发展趋势,现场反应热烈,进一步促进了交流合作。 感恩相遇,感谢有您 ICCAD 2025虽已落幕,但华宇电子创新探索的脚步永不停歇。通过此次展会,我们不仅向业界展示了强大的技术实力与创新活力,更收获了宝贵的市场反馈与合作意向。我们与业界同行共同探讨了集成电路产业的技术演进、市场机遇与挑战,进一步坚定了华宇电子以创新驱动发展的战略方向。 未来,华宇电子将继续深耕集成电路封测领域,持续加大研发投入,推出更多具有市场竞争力先进封测解决方案,与全球伙伴携手,共同推动中国“芯”力量的崛起! 征程万里风正劲,重任千钧再启程。期待再次相遇,共创辉煌!

2025集成电路发展论坛(成都)暨第三十一届集成电路设计业展览会(ICCAD-Expo 2025)将于11月20-21日在成都西部国际博览城二层隆重举行。 届时,华宇集团将携最新封测产品和技术精彩亮相。 展会信息 时间:2025年11月20日-21日 地点:成都西部国际博览城二层 展位:D103-D104 演讲信息 论坛:先进封装与测试(一) 主题:探索先进封装FCBGA发展机遇与挑战 演讲者:王钊 | 池州华宇电子科技股份有限公司 | 研发高级经理 日期:2025年11月21日 | 星期五 时间:13:50-14:10 本届大会以“成渝同芯,同屏共振”为主题,大会聚焦AI芯片、国产EDA、RISC-V、先进存储、Chiplet、异构集成、3DIC、硅光技术等未来趋势与热点,国内外极具代表性IC企业悉数登场。大会从IC设计到先进工艺,从芯片制造到先进封测,从新产品、新技术到新应用,构建并推动了集成电路产业链上下游的深度耦合。

华宇电子提供专业的DDR4 & LPDDR4存储芯片封测服务,覆盖从晶圆来料检测到成品包装的全流程。 DDR4:WBGA78B(11*7.5)/WBGA96B(13*7.5) LPDDR4:FBGA14.5*10(200B) 公司凭借先进设备、严格工艺控制和全流程服务,可为客户提供高可靠Memory芯片封测解决方案。 产品请联系: 【Memory类产品】业务/技术咨询: 羊先生18956642996 宁先生15205668832 【BGA类产品】业务/技术咨询: 孙先生18956622837 姚先生13365801569
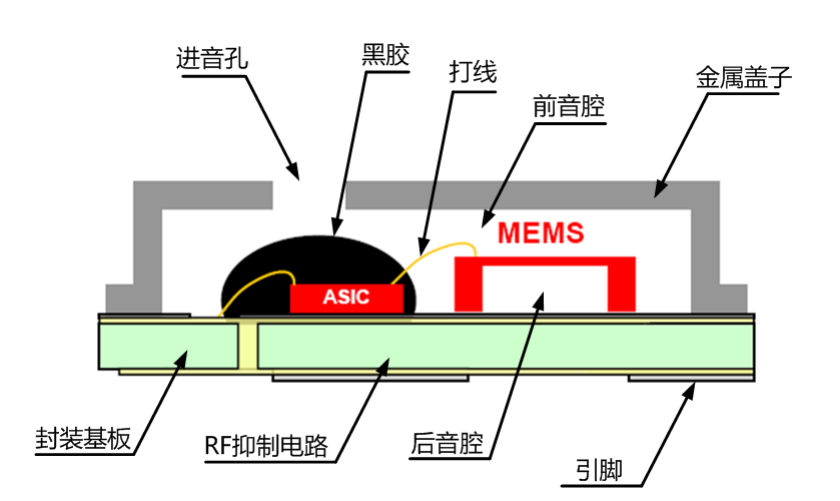
华宇电子提供专业的MEMS麦克风芯片封测服务,覆盖从晶圆来料检测到成品包装的全流程。 硅麦又称MEMS麦克风,是基于MEMS技术制造的麦克风,由MEMS声压传感器芯片、ASIC芯片、音腔和RF抑制电路组成,MEMS声压传感器是一个由硅振膜和硅背极板构成的微型电容器能将声压变化转化为电容变化,然后由ASIC芯片将电容变化转化为电信号,实现“声–电”转换。 硅麦的结构 MEMS声压传感器 MEMS声压传感器实际上是一个由硅振膜和硅背极板组成的微型电容器,硅振膜能感测声压的变化,将声压转化为电容变化。 公司凭借先进设备、严格工艺控制和全流程服务,可为客户提供高可靠MEMS麦克风封测解决方案。
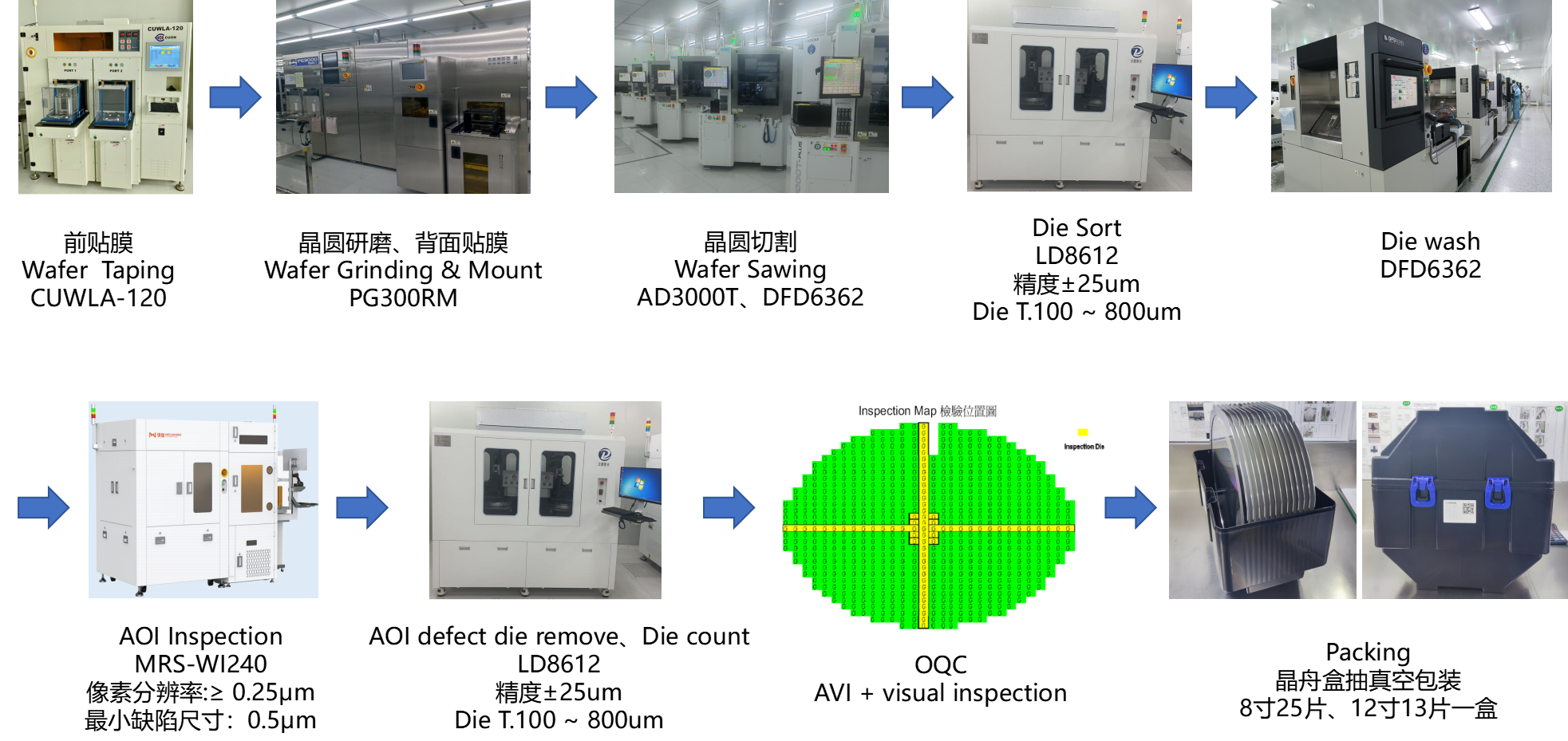
Recon Wafer Process(晶圆重构): 华宇电子提供专业的8英寸和12英寸Recon Wafer 服务,覆盖从晶圆来料检测到成品包装的全流程。 技术优势 高精度加工:切割崩边≤5μm,缺陷检测分辨率0.5μm。 严格品控:多环节AOI检测,洁净度达颗粒残留≤10颗(≥0.1μm)。 成熟工艺 支持12英寸晶圆低应力BG膜贴合、无气泡作业。 分选效率UPH 20K,支持13 BIN分类,适配图像传感器、IC等多种芯片。 质量与交付 包装标准:真空晶舟盒(8英寸25片/盒,12英寸13片/盒)。 符合行业高良率要求,提供稳定量产服务。 Stealth Dicing Process(激光隐切): 华宇电子提供专业的8英寸和12英寸 Stealth Dicing 服务。 技术特点 完全干燥工艺:无需冷却液或其他介质,减少污染风险。 无截口损失:切割过程中材料损耗极低,提升利用率。 无切屑:避免碎屑对精密器件的影响,提高成品率。 高弯曲强度:切割后的材料结构更稳定,适用于高应力环境。 切割道:适应更窄的切割道宽度。 隐切原理 隐形切割技术可将能够穿透材料的波长的激光光束聚焦,在内部聚焦并形成晶圆破裂的起点(改性层:隐形切割层,以下称为“SD 层”),然后向晶圆施加外部应力,将其分离。该过程主要由两部分组成,一般被称为激光改制过程与晶圆扩展分离过程, 隐切激光改制过程 激光光束聚焦在晶圆内部,形成 SD 层以分离晶圆。 裂纹也从 SD 层形成,而 SD 层在内部朝向晶圆的顶部和底部表面形成,这些裂纹通过激光光束扫描沿着计划的切割线连接。此外,为了切割 MEMS 器件等厚晶圆,在厚度方向上形成多个 SD 层,然后连接裂纹。 根据SD层行为可以分为 晶圆扩展分离过程 通过胶带膨胀等行为在周边方向上拉紧胶带,对已形成 SD 层的晶圆施加外力。这会对晶圆的内部裂纹状态施加拉应力,并使裂纹延伸到顶部和底部表面,从而分离晶片。由于晶圆分离是通过延伸裂纹进行的,因此没有应力施加在器件上。此外,由于基本上没有截口损失,这会提高芯片成品率。 Machine model:DISCO DFL7362、DISCO DDS230 公司凭借先进设备、严格工艺控制和全流程服务,可为客户提供高可靠性Recon Wafer & Stealth Dicing 解决方案。

引 言 2025年第30届SEMICON SOUTHEAST ASIA东南亚半导体展是东南亚地区半导体行业的重要展会,汇集了来自全球的半导体设备、材料和服务供应商,今天在新加坡滨海湾金沙会展中心举行,此次展会聚焦可持续制造、绿色技术及半导体产业链创新。华宇电子首秀展会,与全球伙伴相聚、共话产业发展 展会介绍 一年一度的亚洲新加坡国际半导体展览会(SEMICON Southeast Asia)是东南亚规模最大的半导体设备展览会。本次展览面积24000平方米,展商数量570家,观众人数超过20000人。本次展会聚焦半导体技术创新,旨在拓展全球电子制造供应链,为行业带来前沿趋势与市场机遇。 展会盛况 新加坡半导体展览会SEMICON Southeast Asia 企业亮点 中国最具一站式封测服务的企业 公司分布长三角、珠三角、服务全球芯片设计公司,为客户提供就近化服务 掌握产品设计技术:封装设计、基板设计、热学仿真、测试硬件与程序设计 能够及时响应开发和批量生产 总 结 作为国内领先的封测服务提供商,公司始终以技术驱动品质,服务赋能客户为核心理念,依托智能化生产制造和全球化供应链体系,为客户提供从设计支持到量产交付的一站式服务。 未来,公司将继续深耕高性能、高密度、高可靠性封测技术研发,布局大容量存储与射频芯片封测服务,与全球合作伙伴共建开放创新的产业生态链。我们诚邀业界同仁携手同行,以技术突破定义行业高度,以精诚合作共赢智能时代! 诚邀业界同仁莅临池州华宇电子展位B2530交流洽谈!