Recon Wafer Process(晶圆重构):
华宇电子提供专业的8英寸和12英寸Recon Wafer 服务,覆盖从晶圆来料检测到成品包装的全流程。
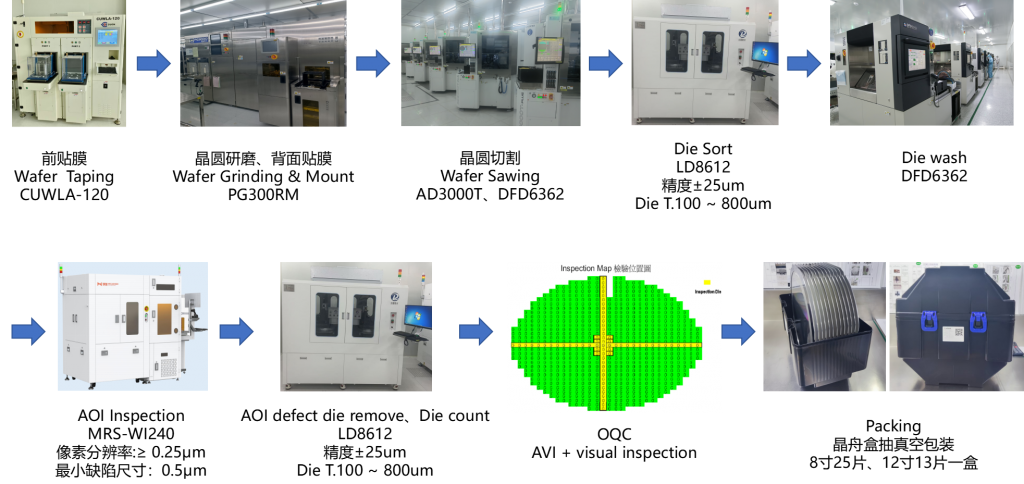
技术优势
高精度加工:切割崩边≤5μm,缺陷检测分辨率0.5μm。
严格品控:多环节AOI检测,洁净度达颗粒残留≤10颗(≥0.1μm)。
成熟工艺
支持12英寸晶圆低应力BG膜贴合、无气泡作业。
分选效率UPH 20K,支持13 BIN分类,适配图像传感器、IC等多种芯片。
质量与交付
包装标准:真空晶舟盒(8英寸25片/盒,12英寸13片/盒)。
符合行业高良率要求,提供稳定量产服务。
Stealth Dicing Process(激光隐切):
华宇电子提供专业的8英寸和12英寸 Stealth Dicing 服务。
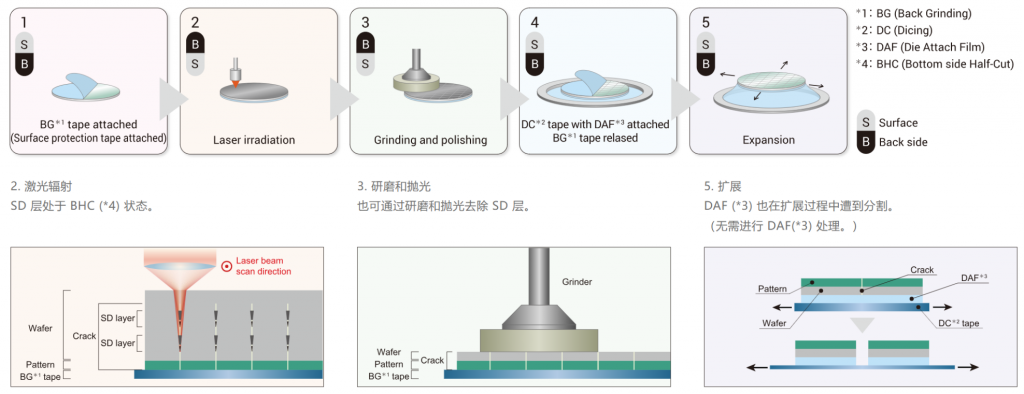
技术特点
完全干燥工艺:无需冷却液或其他介质,减少污染风险。
无截口损失:切割过程中材料损耗极低,提升利用率。
无切屑:避免碎屑对精密器件的影响,提高成品率。
高弯曲强度:切割后的材料结构更稳定,适用于高应力环境。
切割道:适应更窄的切割道宽度。
隐切原理
隐形切割技术可将能够穿透材料的波长的激光光束聚焦,在内部聚焦并形成晶圆破裂的起点(改性层:隐形切割层,以下称为“SD 层”),然后向晶圆施加外部应力,将其分离。该过程主要由两部分组成,一般被称为激光改制过程与晶圆扩展分离过程,
隐切激光改制过程
激光光束聚焦在晶圆内部,形成 SD 层以分离晶圆。
裂纹也从 SD 层形成,而 SD 层在内部朝向晶圆的顶部和底部表面形成,这些裂纹通过激光光束扫描沿着计划的切割线连接。此外,为了切割 MEMS 器件等厚晶圆,在厚度方向上形成多个 SD 层,然后连接裂纹。
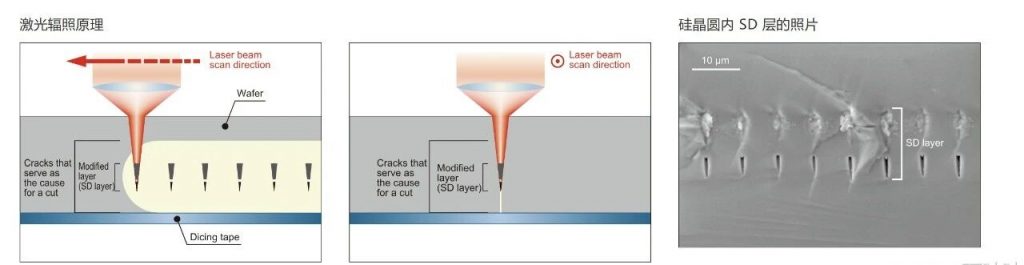
根据SD层行为可以分为
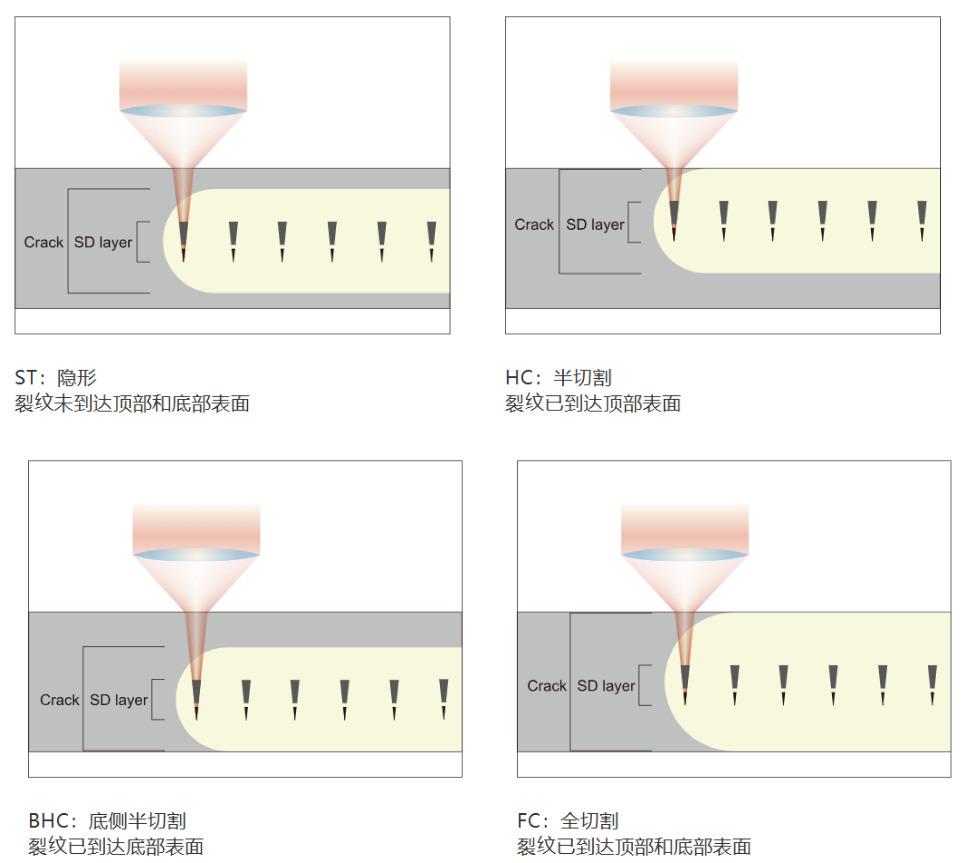
晶圆扩展分离过程
通过胶带膨胀等行为在周边方向上拉紧胶带,对已形成 SD 层的晶圆施加外力。这会对晶圆的内部裂纹状态施加拉应力,并使裂纹延伸到顶部和底部表面,从而分离晶片。由于晶圆分离是通过延伸裂纹进行的,因此没有应力施加在器件上。此外,由于基本上没有截口损失,这会提高芯片成品率。
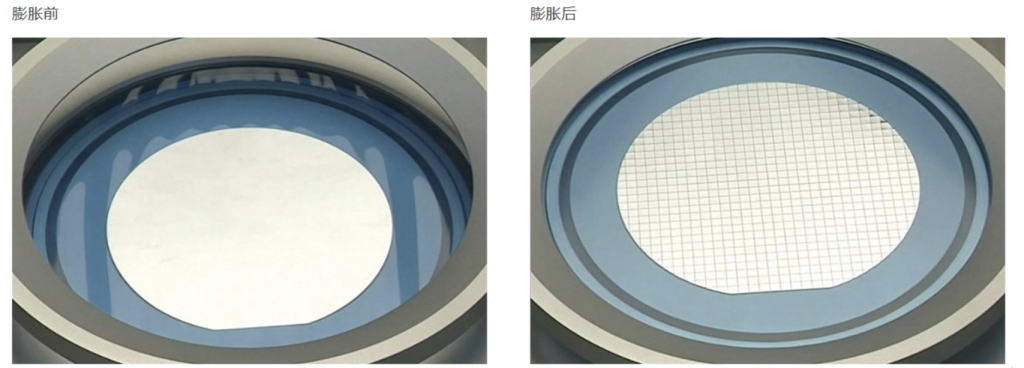
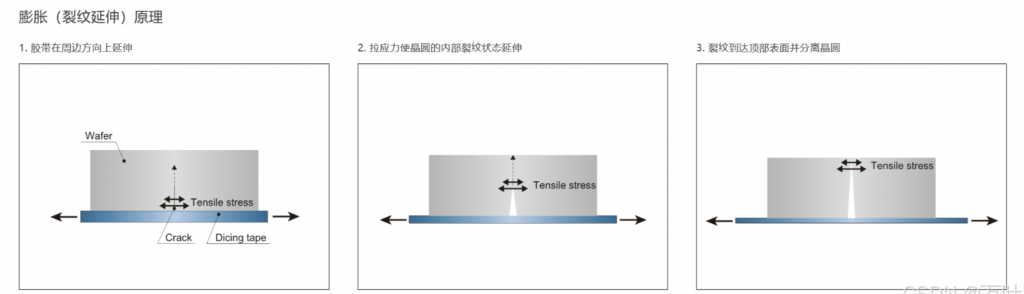
Machine model:DISCO DFL7362、DISCO DDS230

公司凭借先进设备、严格工艺控制和全流程服务,可为客户提供高可靠性Recon Wafer & Stealth Dicing 解决方案。


